先进封装时代,那些传统OSAT封测厂怎么办?
从媒体的角度来看,某一类技术的大热在于讨论度。下周很快要到来的SEMICON China,我们接到了不少先进封装(advanced packaging)技术相关设备制造商的邀约,主题与展示都和先进封装相关——这多少表明了先进封装技术的热门和未来潜力,虽说好像先进封装高速发展的呼声已经很高了。
最近Digitimes消息又说,台积电准备将CoWoS封装技术的产能从每月8000片wafer,提升到今年底的11000 WPM;而到2024年底则要到20000WPM。英伟达将占据其中一半的产能,据说AMD也在寻求额外的CoWoS产能。数据中心的通用加速GPU应当是个中主力,包括最近热度颇高的AMD Instinct MI300和英伟达H100。xBuesmc
前不久台积电刚刚开启了先进后道Fab 6工厂(Advanced Backend Fab 6),针对前道3D堆叠SoIC技术(包括CoW和WoW)和后道3D封装技术(InFO和CoWoS)做产能扩充。这家工厂的部分能力和产能对于多chiplet封装与测试很重要。xBuesmc
目前台积电CoWoS(Chip-on-Wafer-on-Substrate)先进封装技术最大的客户就是英伟达和AMD,两者占到CoWoS产能的大约七八成,随后是博通(Broadcom)大约有10%的占比;其余产能由大约20家fabless芯片设计企业共享。先进封装技术是需要特别的生产设备的,据说关键设备的交期已经达到3-6个月,则台积电扩充CoWoS技术的产能也可能受到了一定的限制。xBuesmc
 xBuesmc
xBuesmc
去年《电子工程专辑》8月刊封面故事已经谈到过,先进封装技术的本质,是缓解原本芯片制造前道(front-end)流程的瓶颈——也就是器件微缩不再那么容易;转而借助后道(back-end)流程上的创新,来持续摩尔定律的辉煌。这个过程实际是某种程度发生了价值重心的变迁的。xBuesmc
原来基本由OSAT(outsourced semiconductor assembly and test companies)传统封测企业做封装的模型发生了很大变化,因为先进封装要求复杂技术和先进工艺,传统OSAT的参与度如何是个问题。xBuesmc
而在即将发布的今年7月刊封面故事里,我们还将提到chiplet和先进封装技术,对于芯片设计流程和价值链的变革:上游IP供应商的角色可能发生变化。这些都是新技术给行业带来的颠覆,而且是在潜移默化中发生的。xBuesmc
借着即将与先进封装上游设备制造商探讨相关技术与行业革新的机会,我们先来概括性地谈谈先进封装技术在行业中的发展情况。恰好上个月麦肯锡(McKinsy & Company)发布了一些相关先进封装技术的数据。这些数据将更有利于我们理解其发展阶段。xBuesmc
不同封装技术的市场价值
对于先进封装技术感兴趣的读者,仍然建议阅读《电子工程专辑》去年的封面故事文章,其中对不同的先进封装技术做了比较详尽的解读。从广义上来看,“先进封装”的本质,在于以显著更高密度的I/O来进行封装——具体接触点间距密集到何种程度算是“先进”,似乎并没有明确标准。而部分狭义的“先进封装”定义,只在2.5D/3D封装方案。xBuesmc
现在普遍的认知是2.5D、3D封装必然属于先进封装范畴,另外技术文章里经常提到的扇出型(Fan-out)封装也属于先进封装——我们这次参与SEMICON China的很多厂商都准备跃跃欲试地聊fan-out技术。这里我们再借助麦肯锡的图,做个简单的解释。xBuesmc
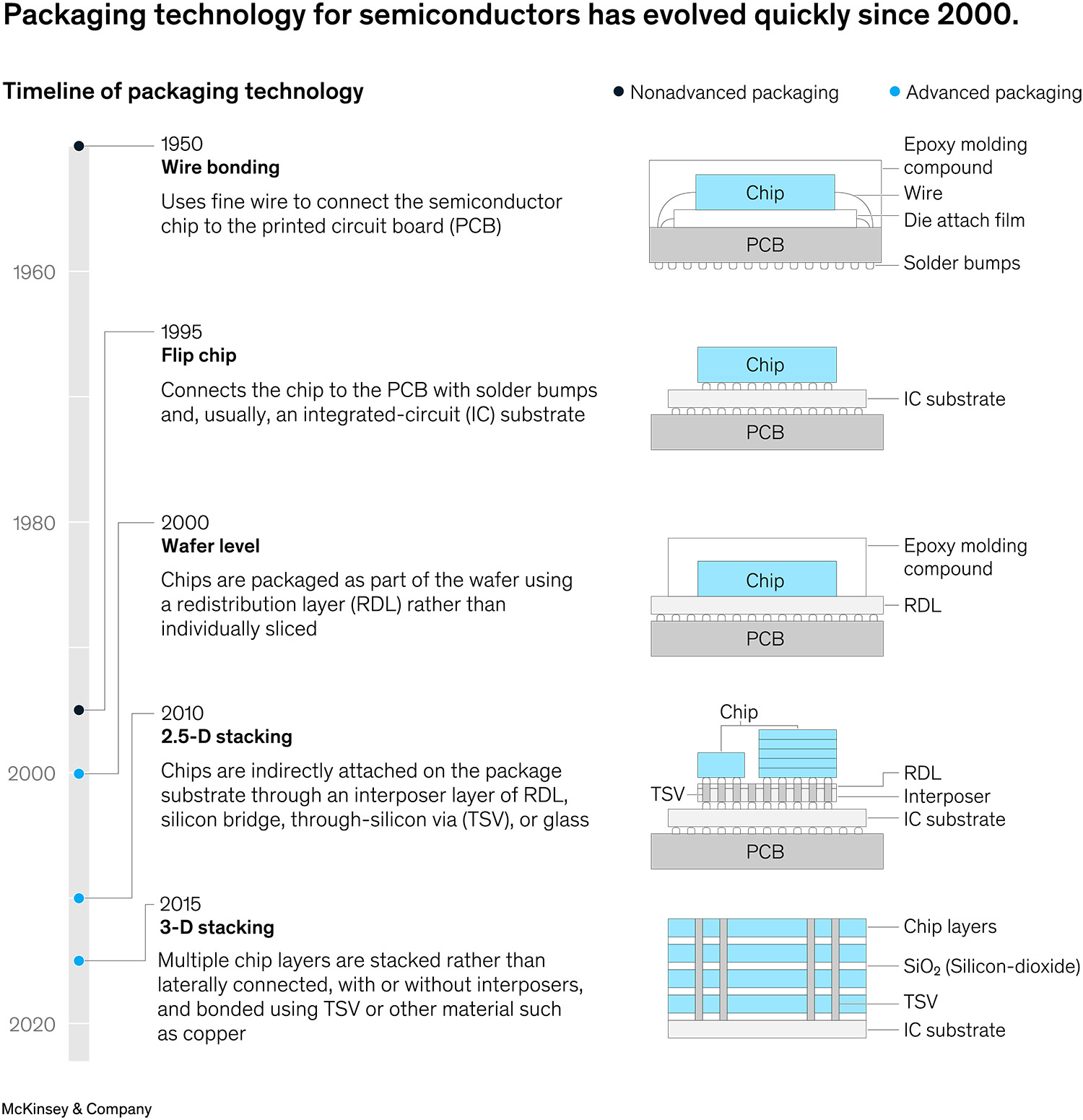 来源:McKinsey & CompanyxBuesmc
来源:McKinsey & CompanyxBuesmc
“封装”也就是产品做好了以后,要包装起来。对于芯片而言,不光是密封确保内部die的可靠性,在die或者理解为一片硅造出来以后,要用某种方法令其与外部世界互通,包括供电、信号互联。早年用引线键合(wire bonding)方案来达成内部芯片与外部PCB的互联,需要用到焊球、金属线——这是一种很直观的封装方式。xBuesmc
麦肯锡的数据是,预计到2031年,引线键合市场价值会达到160亿美元,从现在到2031年的CAGR(年复合增长率)为2.9%。xBuesmc
后来发展出了芯片倒装(flip chip)技术,就是在die造好之后,翻个面——即原本在底下的晶体管到了上面,而原本在上的金属互联层在下方——通过所谓的bump凸起连接到封装基板上。某些企业会将bump间距较小的封装也称作“先进封装”。实际上芯片倒装也是后续诸多先进封装技术的基础,它实现了更小的间距、更高的I/O密度。xBuesmc
倒装工艺在电脑、手机的CPU、SoC等芯片上很常见。麦肯锡数据为当前芯片倒装市场价值在270亿美元,2030年会达到450亿美元。xBuesmc
此后出现的WLP(wafer-level packaging,或WLCSP)晶圆级封装,顾名思义是在晶圆级(而不是在切割之后单独的die级)就进行电气连接布局。WLP相比更早期倒装方案的差异,在于die和PCB之间的substrate,换成了RDL(redistribution layer,重新分布层),可达成更小的封装、更好的导热性。xBuesmc
 xBuesmc
xBuesmc
来源:Fan, Xuejun. “Wafer level packaging (WLP): Fan-in, fan-out and three-dimensional integration.” 2010 11th International Thermal, Mechanical & Multi-Physics Simulation, and Experiments in Microelectronics and Microsystems (EuroSimE) (2010): 1-7.xBuesmc
WLP有两种形式,fan-in和fan-out(如上图)。麦肯锡在文章中说,fan-in的WLP封装通常用于低端手机之类的应用,RDL层路径通往die中央。而在fan-out扇出型封装方案里,RDL层的边界超出die范围之外,其I/O的整体路径从die引出,到RDL层扩散开去,RDL层扩展到die以外的部分叫“fan-out区域”,所以叫“扇出型”。xBuesmc
典型方案如台积电的InFO(Integrated Fan-Out)晶圆级封装。此前JCET做过一个Fan-In和Fan-Out WLP封装工艺流程的动画视频,有兴趣的可前往观看。其实Fan-Out虽然叫WLP晶圆级封装,但在流程上首先还是要把做好的die从wafer上切下来;但切下来的这些die还要再放到新的载体wafer上再做后续操作…具体的就不展开了。xBuesmc
麦肯锡数据,fan-out型WLP封装市场价值大约为15亿美元。汽车、移动、网络设备和HPC高性能应用是此类高级封装方案的常客。目前最大的WLP技术供应商就是台积电。xBuesmc
2.5D封装是在此基础上,将更多片的die借助某个中介(比如硅中介silicon interposer)连起来,集成到同一个封装内。现在比较知名的2.5D封装技术典型如采用硅中介的CoWoS-S(台积电);用硅桥(silicon bridge)的CoWoS-L(台积电)和EMIB(Intel);RDL层本身也可以作为中介层,CoWoS-R就是其中代表。xBuesmc
麦肯锡还提到下一代中介层材料的glass(玻璃?),据说可在高频带宽的前提下达成低成本和低功率损耗。xBuesmc
而3D堆叠自然就是将die在垂直方向叠起来,除了用microbump和TSV的堆叠方案之外,还有hybrid bonding混合键合,此前我们也不止一次撰文探讨过了。xBuesmc
几类市场参与者扮演的不同角色
对于领先的IDM和foundry厂而言,先进封装也成为重要的卖点。台积电财报显示,2022年年度营收中7%来自先进封装。虽然台积电预期今年的先进封装占比仍然会在6-7%之间,未来的增长潜力还是相当大的。xBuesmc
我们现在听到先进封装,大约首先冒出来的名字就是台积电、Intel、三星、日月光等。实际上这些技术的投入,也不是一朝一夕的。而其他市场参与者要追赶就显得很困难。加上这些技术要求相当的产品经验,没有量的积累也很难起得来,就进一步加剧了技术差距。xBuesmc
比如2.5D和3D封装,需要掌握的技术基础就是interposer中介层和hybrid bonding混合键合技术能力。Interposer需要对应的材料与生产制造技术方法;而hybrid bonding则涵盖CMP(化学机械平台化)、极高的互联精度,在设备和know-how方面都是需要积累的。此前我们采访Intel,Intel就提到做hybrid bonding在互联间距之外实际还牵扯到很多别的技术挑战。xBuesmc
另外值得一提的是,先进封装的封装设计需要在最初架构阶段就做考量——尤其如果加入chiplet,则设计不同阶段的整体“左移”都对各环节参与者提出了新的要求,如此才能从整个系统的角度确保设计的可靠与高效。这同时意味着芯片设计客户对相应的先进封装技术供应商有着更高的粘性。xBuesmc
麦肯锡在报告中提到,对于foundry厂而言,要获得高价值的fabless客户,就需要协同开发先进封装解决方案:在芯片架构设计阶段和最初针对设计验证的shuttle run时,就可能需要协同开发。麦肯锡表示,由于高性能芯片以及封装导致的芯片设计复杂度提升,这样的合作会变得越来越重要。xBuesmc
所以对于非头部,但掌握一定先进封装技术的foundry厂(被麦肯锡称作fast followers)来说,将自己摆在,从设计阶段就针对先进封装帮助客户生产产品的位置,会很重要。除此之外,还需要寻求design house的帮助,从IP开发到设计和制造,design house都将扮演重要角色,包括RTL设计、所需的功能高层级描述,以及逻辑测试和布局布线。还有就是要具备一站式交付能力。xBuesmc
 xBuesmc
xBuesmc
在先进封装技术的问题上,主要的参与者很显然囊括有三个角色:逻辑与存储芯片IDM、具备先进或成熟工艺的foundry厂、OSAT。事实上,比较符合直觉的情况是:更早部署先进封装技术,而且已经处在领跑位置的参与者(典型如台积电、Intel,恰好对应了前两个角色;另外还有这里没怎么谈的是应用3D堆叠先进技术的存储器制造商),必然是战局里的赢家,即便初期产能受限,可能会成为其阻碍。xBuesmc
而更多拥有部分先进封装技术能力的跟随者,也能获得市场,只不过在高端解决方案上并不会那么容易就获得稳定的客源,或者全面掌控设计/制造能力。所以寻求协同合作会很重要。xBuesmc
但其实更多人关心的或许是传统做后道的OSAT封测厂在此扮演什么角色,至少麦肯锡认为,在高端的先进封装市场,OSAT以及技术水平处在较低级别的foundry和IDM,这些角色的发挥空间会很有限。与其直接参与竞争,不如提供对应的低端解决方案或者寻求在某些价值链上做个合作者。即便个别比较领先的OSAT在大量投入以后能够做fan-out扇出型封装方案,2.5D、3D堆栈能力仍然是滞后的。xBuesmc
这其中的合作可以是,和头部有能力做TSV、RDL光刻、hybrid bonding等核心技术的玩家合作,OSAT还是可以继续提供中道到后道的服务和工作,如wafer薄化、bump制造等。xBuesmc
另外如本文第一部分提到的,持续到2030年,传统封装技术仍然是要做的,包括引线键合这种已经存在了几十年的技术。况且并不是什么芯片都得用先进封装——就像现在,先进封装的市场价值仍然没那么高;芯片如果没有量自然也无法承担先进封装现如今的成本。xBuesmc
但显然要在先进封装技术时代分得一杯羹是需要投入的,无论是做先进封装技术本身,还是将其纳入企业未来的发展策略,令自身化作其中的某个环节。不过我们认为,chiplet、异构集成和先进封装的发展,未来可能呈现出新的市场格局;这是技术对于产业链、价值链的变革,未来的不确定性还很大;观察芯片设计上游的新动向,制定新的发展策略,对于制造和封测参与者都十分关键。xBuesmc
先进封装的未来价值
最后给张图,是麦肯锡预测的2026年先进封装在不同应用领域的市场价值变化。其中HPC、网络通信应用主要是来自AI芯片、边缘计算,以及消费电子设备中的网络芯片。毕竟扇出型封装能够给到对应的小尺寸和并不算高的成本。xBuesmc
 xBuesmc
xBuesmc
2.5D封装应用主要来自HPC应用,以数据中心为主。其实Intel最近改变桌面CPU的系列产品命名,将Meteor Lake称作“英特尔酷睿Ultra”第1代处理器,就可以看做PC行业步入2.5D/3D先进封装的标志,不止是数据中心,只不过数据中心服务器芯片仍将是先进封装技术打头阵的先锋——国产的某些GPU、AI芯片都已经开始应用此类方案。xBuesmc
而3D堆叠,存储以及各类加速计算芯片的应用已经进入加速期,毕竟连民用市场的CPU都开始用3D V-Cache了,数据中心GPU上的HBM内存,以及某些大规模AI芯片把电源相关的部分和计算die做堆叠(如Graphcore Bow)都不是新鲜事了。这是市场进化的必然。xBuesmc
至于未来产业链的整体变迁,到2026年还可以再做观察。在这个过程里,会有好几类市场参与者都需要对自己的角色做重新审视与定位。xBuesmc
-
微信扫一扫,一键转发
-

关注“国际电子商情” 微信公众号
- 西部数据与闪迪本周完成拆分:HDD与SSD两大业务独立发展
国际电子商情17日讯 西部数据(Western Digital)和闪迪(Sandisk)预计最快在本周完成拆分。拆分后,西部数据将专注于硬盘驱动器(HDD)业务,而闪迪将全力拓展NAND闪存和固态硬盘(SSD)领域……
- 特朗普政府重审“芯片法案”:390亿美元补贴或生变
国际电子商情2月14日讯 美国半导体产业的未来可能再次面临重大转折。
- Q1财测大降25%,安森美称将“精简”业务
在全球半导体行业面临增长放缓的背景下,安森美(onsemi)在2024年第四季度业绩下滑,并预计2025年第一季度营收将大幅下降。为应对市场挑战,公司宣布将采取“精简”业务等措施以提升竞争力……
- 半导体市场增长强劲,2024年销售额首破6000亿美元大关
国际电子商情10日讯 最新数据显示,2024年全球半导体行业迎来了历史性突破,销售额首次突破6000亿美元大关,达到6276亿美元,同比增长19.1%……
- 韩国芯片巨头Magnachip寻求再次出售,LX集团或成最大赢
国际电子商情8日讯 在显示器行业长期低迷的背景下,曾因美国干预而搁置出售计划的韩国芯片制造商Magnachip,在时隔数年后再度寻求出售……
- 中国对美进口汽车等商品加征关税,2月10日生效!
国际电子商情5日讯 中国财政部4日在官网发文,明确自2月10日起对原产于美国的部分进口商品加征关税。此次关税调整是针对美国月初宣布对中国输美产品加征10%关税的反制措施……
- 恩智浦(NXP)或在全球裁员1800人
国际电子商情5日讯 据外媒报道,荷兰半导体公司恩智浦(NXP)近日宣布,由于全球经济挑战和市场压力的增加,公司计划在全球范围内裁员1800人。
- 2024年美国专利申请量50强榜出炉!华为、京东方、长鑫存
国际电子商情讯 美国商业专利数据库IFI Claims日前公布了2024年度美国专利授权量50强名单。这份榜单不仅反映了各大公司的创新能力,还揭示了全球科技行业的竞争格局。
- 罗姆半导体换帅:新任CEO能否力挽狂澜?
国际电子商情21日讯,日本罗姆半导体公司近期公布了一项重要人事变动决定。此次人事调整被罗姆视为加强管理体系、提升企业价值的关键举措……
- 美国管制新规对AI芯片影响几何?台积电董事长这样说……
在当前全球科技竞争愈发激烈的背景下,美国政府对AI芯片实施的出口管制政策成为了业界焦点。国际电子商情16日获悉,台积电董事长魏哲家在今(16)日法说会上对此政策的影响进行了回应……
- 继美光、三星、Kioxia后,又一存储大厂宣布减产NAND闪存
国际电子商情16日讯 在全球NAND闪存市场供过于求的背景下,闪存价格已经连续四个月下跌。为此,SK海力士日前也宣布加入减产行列,这家韩国存储芯片制造商计划在2025年上半年将其NAND闪存产量减少10%……
- 全球半导体市场持续增长,但区域表现分化趋势明显
国际电子商情13日讯 据美国半导体行业协会(SIA)日前发布的数据显示,2024年11月全球半导体销售额达到了578亿美元,环比增长1.6%,连续第八个月实现月度增长,并创下历史新高。然而,在这一整体增长的背景下,不同地区的市场表现却呈现出显著的差异...
- 英飞凌预计2025财年AI业务营收将突破6亿欧元,未来两年内有望超10
美通社消息,3月14日,“2025英飞凌消费、计算与通讯创新大会”(ICIC2025)在深圳举行。本届大会汇聚600多位业界精
- 湖南公布电子信息制造业重点项目,涉13个MLED、显示类项目
近日,湖南省工信厅发布了《2025年湖南电子信息制造业重点项目名单》,涵盖先进计算、音视频、新一代半导体、人
- 总投资7.6亿,惠科东莞平板显示项目二期开工
3月15日,质鼎集团公众号消息,惠科东莞平板显示集群电子商务项目二期正式开工。
- 中国台湾20家电子企业2024年第四季度和全年财报汇总,富士康、台积
富士康、台积电、广达、华硕、联发科、友达光电等中国台湾20家电子企业2024年第四季度和全年财报汇总。
- 全球LED显示屏市场机遇与挑战分析
近年来,LED显示屏市场持续演进。回顾2024年,行业呈现出哪些发展态势?展望2025年及未来,市场又将面临哪些机遇与
- 索尼发布全新RGBLED背光技术
近日,索尼正式发布新一代RGBLED背光技术系统,可实现4000尼特峰值亮度。索尼计划该系统将于2025年开始量产,并将
- AI爆发,本土先进封装如何突破?
AI芯片是半导体最大的增长点,先进封装则是制造AI芯片的关键技术。此前英伟达H100成本约3000美元,而用先进封装
- 欧美车用固态电池验证加速,预计最快2026年逐步实现量产
截止2024年底,17家欧美固态电池企业融资总额已突破42亿美元。
- 中国半导体走向幕后时代
曾几何时,中国半导体几乎不断有大基金投资、大项目上马,以及美国制裁的新闻。长期处于聚光灯下,中国半导体成为
- Dynabook(原东芝PC部门)在退出10年后重返美国消费市场
Dynabook在退出十年后宣布重返美国消费市场。
- 中国大陆PC市场出现反弹,预计2025年将实现3%的增长
Canalys最新数据显示,受到消费需求激增8%的推动,2024年第四季度中国大陆的PC市场开始复苏,同比增长2%。
- 受苹果手机年末生产高峰及中国补贴政策带动,4Q24智能手机产量季增
根据TrendForce集邦咨询最新调查,2024年第四季由于Apple(苹果)手机生产进入高峰,以及中国部分地方提供消费补贴
- 德州仪器推出全球超小型MCU,助力微型应用创新
德州仪器近日推出了全球超小型 MCU,进一步扩展了品类齐全的 Arm® Cortex®-M0+ MSPM0 MCU 产品组合。
- 芯向未来,2025英飞凌消费、计算与通讯创新大会成功举办
创新是企业持续发展最大的价值。
- 闪迪独立上市后首秀“肌肉”: UFS 4.1新品、企业级SSD满足云到端
“闪迪(Sandisk)又回来了!”在3月12日的存储年度盛会CFMS MemoryS 2025上,闪迪公司全球产品副总裁Eric Spa
- 摩尔斯微电子推出MM8102 Wi-Fi HaLow芯片,推动物联网新浪潮
摩尔斯微电子推出合规的Wi-Fi HaLow片上系统(Soc),开启欧洲连接技术新纪元。超低功耗、远距离连接功能现已为
- 存储大佬们都说了啥?MemoryS 2025 产业大咖演讲内容合集
CFMS | MemoryS 2025已圆满落幕,期间包括三星电子、长江存储、铠侠、美光、闪迪、高通、Arm、慧荣科技、S
- 安森美推出面向工业应用的先进深度传感器
Hyperlux™ ID iToF 系列将深度测量距离提升至最远 30 米,提高工业环境中的生产效率和安全性
- 西部数据推出大容量存储方案,赋能NAS用户、创意专业人士与内容创
26TB大容量CMR HDD助力WD Red Pro与G-DRIVE/G-RAID系列专业级产品矩阵,赋能数据存储拓展与生产力跃升
- 恩智浦发布全新一代S32K5微控制器系列,推进SDV区域控制架构发展,扩
全新一代MCU可以满足各种区域控制架构和电气化系统需求,助力汽车制造商向软件定义汽车(SDV)过渡。
将出色的高 - 【原厂入驻】聚洵半导体现已入驻iCEasy商城!
聚洵半导体科技(上海)有限公司(Gainsil Semiconductor Technology)于2016年成立于上海张江科学城,是一家全球
- 4月必逛电子展!六大热门新赛道,来NEPCON China 2025一展全看
领域新成果领域新成果4月必逛电子展!AI、人形机器人、低空飞行、汽车、新能源、半导体六大热门新赛道,来NEPCO
- 英飞凌成为全球首个在安全控制器中采用后量子加密算法而获得Comm
后量子加密技术帮助保护数字基础设施免受量子计算机在将来带来的潜在威胁。
- 踏时代之浪,共绘创新可持续新篇章
英飞凌坚信低碳化和数字化是未来十年的关键驱动力,半导体在应对能源挑战和推动数字化转型中扮演着重要角色。

